Anomaly Detection in Semiconductor Manufacturing
Deep Learning for Wafer Map Defect Classification
2026-03-26
Agenda
- Background — Why semiconductor defect detection matters
- Key Concepts — Neural networks, CNNs, transfer learning explained
- Dataset & Exploration — The wafer map dataset
- Data Preprocessing — Encoding, splitting, augmentation
- Phase 1 — Multi-label classification (8 defect types)
- Phase 2 — Multi-class classification (38 defect patterns)
- Results & Evaluation
- Visual Representation
Why Semiconductor Defect Detection?
- Semiconductor chips are in everything — phones, cars, medical devices
- During manufacturing, silicon wafers go through hundreds of process steps
- Defects on the wafer surface cause chip failures
- Traditional inspection: manual review by engineers — slow, subjective, expensive
- Our goal: automate defect pattern recognition using deep learning
The 8 Base Defect Types

What is a Neural Network?
Think of it as a decision-making system inspired by the brain:
- Inputs: Raw data (e.g., pixel values of a wafer image)
- Hidden layers: Each layer learns to detect increasingly complex patterns
- Output: A prediction (e.g., “this wafer has a scratch defect”)
The network learns by example — we show it thousands of labeled wafer images, and it figures out what patterns correspond to each defect type.

What is a Convolutional Neural Network (CNN)?
A CNN is a specialized neural network designed for images.

Why CNN for wafer maps? Defect patterns are spatial — a “ring” defect forms a circle, a “scratch” forms a line. CNNs are built to detect exactly these kinds of spatial structures.
Dataset Overview
Source: Mixed-Type Wafer Map Defect Dataset
- 38,015 wafer map images
- Each image: 52 × 52 pixels
- 3 pixel states:
0= blank (no die)1= normal die (passed test)2= defective die (failed test)
- Labels: 8-dimensional one-hot vector (8 base defect types)
- 38 unique defect patterns (single + combinations)

Data Preprocessing Pipeline
|
Raw Images 52×52 Values: 0,1,2,3 |
→ |
Clean Pixel 3 → 0 |
→ |
One-Hot Encode 52×52×3 3 channels |
→ |
Stratified Split 70 / 15 / 15 |
Stratified Split Ensures All 38 Defect Patterns in Every Set
Dataset
38 patterns
Rare (~200)
Random Split
Missing patterns
in Val/Test
Stratified Split
All 38 preserved
Train / Val / Test
| Split | Samples | Unique Patterns |
|---|---|---|
| Train | 26,610 | 38 |
| Val | 5,702 | 38 |
| Test | 5,703 | 38 |
Per-Label Sample Counts
| Label | Train | Val | Test |
|---|---|---|---|
| Center | 9,100 | 1,950 | 1,950 |
| Donut | 8,400 | 1,800 | 1,800 |
| Edge_Loc | 9,100 | 1,950 | 1,950 |
| Edge_Ring | 8,400 | 1,800 | 1,800 |
| Loc | 12,600 | 2,700 | 2,700 |
| Near_Full | 104 | 22 | 23 |
| Scratch | 13,300 | 2,850 | 2,850 |
| Random | 606 | 130 | 130 |
Phase 1: Detecting the 8 Base Defect Types
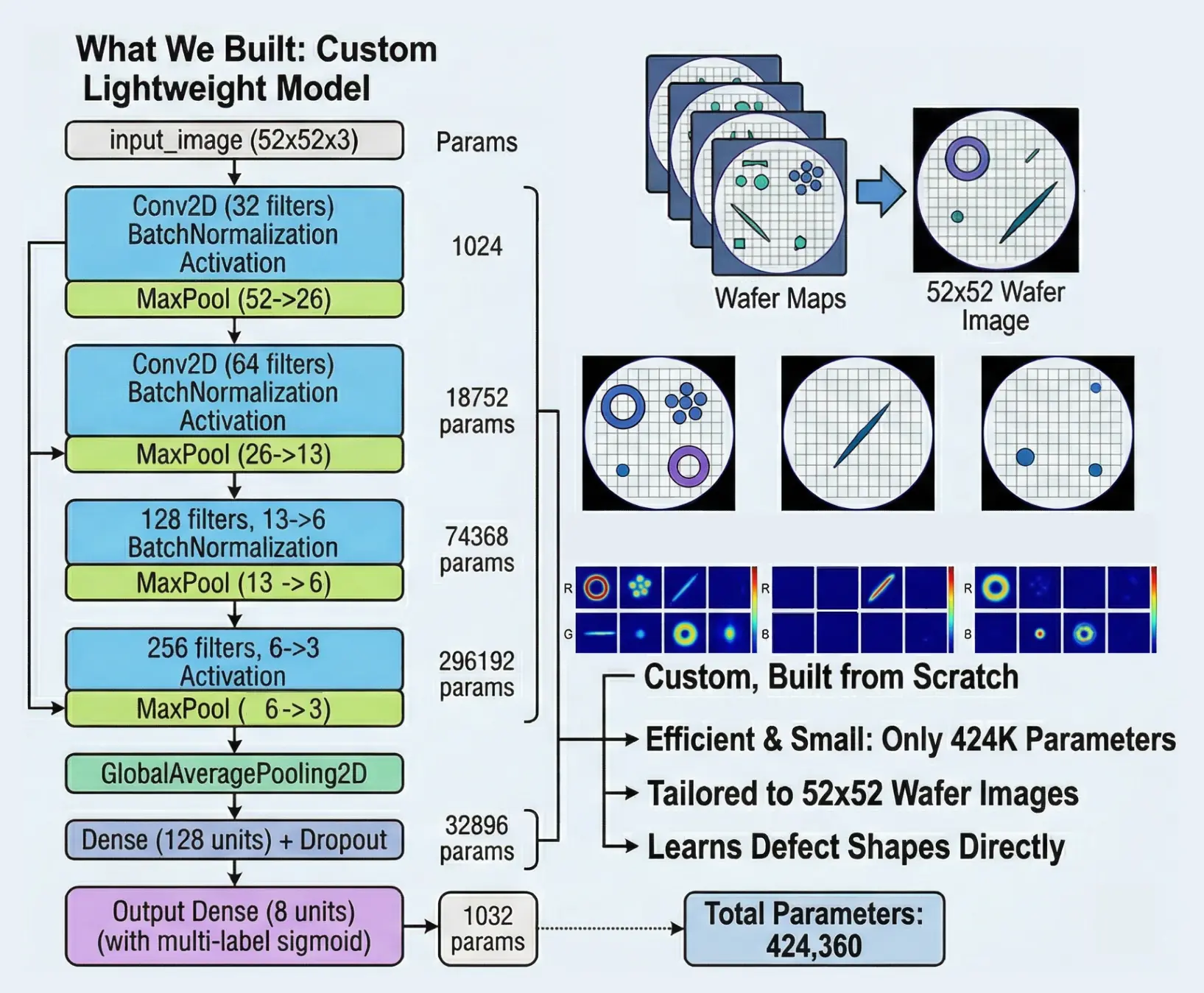
Output (Threshold = 50%)
Center = 80% ✅ Edge Ring = 85% ✅ Scratch = 80% ✅ Donut = 30% ❌ Edge Loc = 40% ❌ Loc = 10% ❌ Near Full = 1% ❌ Random = 23% ❌
How we validated it
- Compared against MobileNetV2 — a model Google trained on millions of images
- If our custom model matches or beats it, we know our approach works
Custom CNN outperforms MobileNetV2


Phase 1 Results
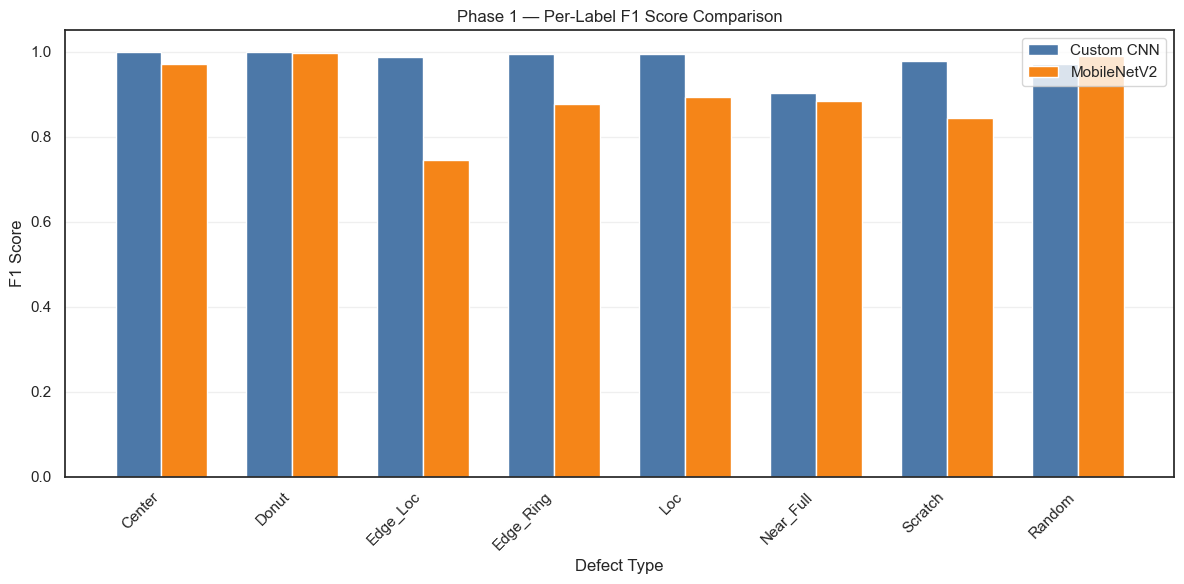
Key observations to highlight:
- Both models achieve strong per-label F1 scores
- Near_Full is the hardest class (fewest samples ~200)
- Custom CNN and MobileNetV2 each have strengths on different defect types
- The per-label class weights in focal loss successfully boost rare-class performance
Phase 2: From 8 Base Types to 38 Defect Patterns
We take our trained Phase 1 model (which learned to detect 8 base defect types) and build on top of it to classify all 38 defect patterns.
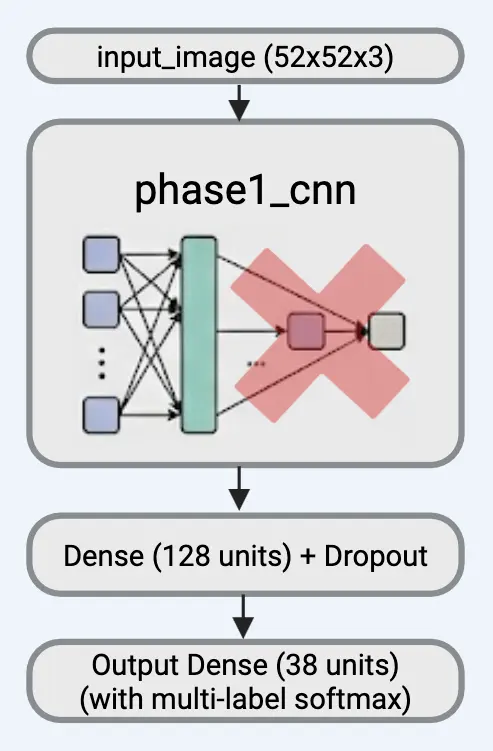
|
Transfer learning from Phase 1 Model Detects 8 base defect patterns (Center, Donut, Scratch, etc.) |
→ |
Phase 2 Model Classify all 38 defect patterns (base + combinations) |
Phase 2 Results — Full Confusion Matrix (38×38)

Phase 2 Results — Single / Normal Patterns

Phase 2 Results — Double Combinations

Phase 2 Results — Triple Combinations

Phase 2 Results — Quadruple Combinations
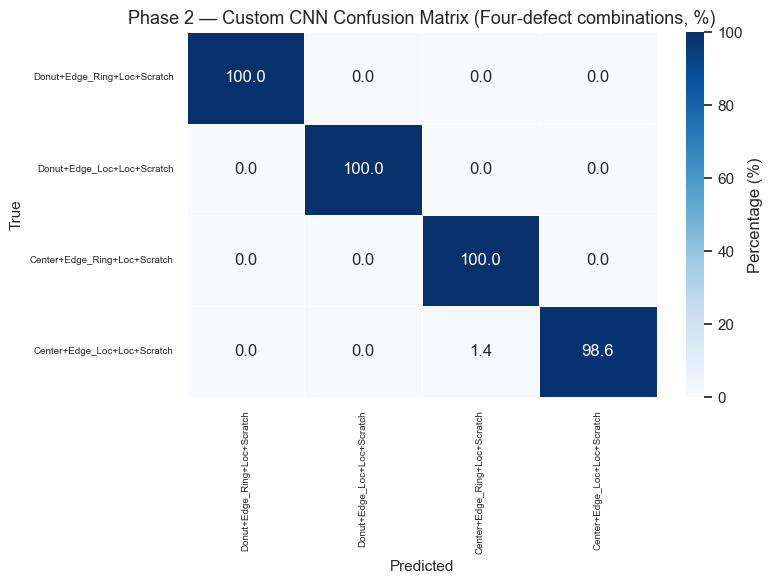
Final Model Comparison
|
Phase 1 — Custom CNN (8-label) |
Phase 1 — MobileNetV2 (8-label) |
Phase 2 — Custom CNN (38-class) |
Phase 2 — MobileNetV2 (38-class) |
|
|---|---|---|---|---|
| Macro F1 | 0.9779 | 0.8998 | 0.9736 | 0.9667 |
| Weighted F1 | 0.9905 | 0.8847 | 0.9735 | 0.9658 |
- Our Custom CNN outperformed MobileNetV2 in both phases
- The Phase 2 Custom CNN (38-class) is our final production model — it can identify all 38 defect patterns with 97%+ accuracy
- Building our own model from scratch proved more effective than using a pre-trained one for this task
How Accuracy is Measured
Example wafer - Center + Loc + Scratch
|
Phase 1: 8 Yes/No Questions |
→ |
Transfer |
→ |
Phase 2: Pick Best Match |
→ |
Accuracy Check |
- Phase 1: Each defect scored independently — above 50% means “present.” Accuracy measured per defect type (F1 score)
- Phase 2: Picks the single highest-probability pattern out of 38. Correct if it matches the true label
- We repeat this for every wafer in the test set — 97%+ are predicted correctly
Live Inference Demo
- Dashboard link
Summary
Our Custom CNN Pipeline:
|
Phase 1 Train our CNN to detect 8 base defect types |
→ |
Phase 2 Reuse Phase 1 knowledge to classify all 38 patterns |
→ |
Final Model 38-class Custom CNN 97%+ accuracy |
Benchmark Comparison:
|
MobileNetV2 Google’s pre-trained model (2.6M params) |
→ |
Same tasks Phase 1 (8 types) Phase 2 (38 patterns) |
→ |
Result Our CNN outperformed on both phases |
Building our own model from scratch proved more effective than using a pre-trained one for this specialized task.
Thank You
Questions?
Appendix
The 8 Base Defect Types
| Defect | Description |
|---|---|
| Center | Defects clustered at wafer center |
| Donut | Ring-shaped pattern in the middle |
| Edge_Loc | Localized defects near the edge |
| Edge_Ring | Defects forming a ring at the edge |
| Loc | Localized cluster anywhere |
| Near_Full | Almost entire wafer is defective |
| Scratch | Linear scratch pattern |
| Random | Randomly distributed defects |
Plus Normal (no defects) and 29 combination patterns (e.g., Center+Scratch)

Key Terms
Activation Functions
- ReLU — hidden layers; if input > 0 pass through, else 0. Simple and avoids vanishing gradients
- Sigmoid — Phase 1 output; squashes to 0–1 per label. Each neuron independently says yes/no
- Softmax — Phase 2 output; converts scores to probabilities that sum to 1
Loss Functions
- Binary Focal Loss (Phase 1) — down-weights easy examples, focuses on hard/rare ones
- Sparse Categorical Crossentropy (Phase 2) — standard multi-class loss with class weights
Regularization
- Batch Normalization — normalizes layer inputs → faster, more stable training
- Dropout (0.5) — randomly silences 50% of neurons → prevents overfitting
- GlobalAveragePooling2D — averages each feature map instead of flattening → fewer parameters
- Early Stopping — stops training when validation loss plateaus
- Learning Rate - How big a step the model takes when updating its weights. Too big = overshooting; too small = too slow.
What is Transfer Learning?
Transfer learning means reusing knowledge from one task to improve performance on another.
Analogy: Imagine hiring someone who already knows how to identify shapes, edges, and textures, and just teaching them the specific wafer defect categories.
We use transfer learning twice in this project:
- Phase 1 → Phase 2: First learn to predict the 8 base defect types, then transfer that learned knowledge to predict all 38 defect patterns
- MobileNetV2 → Our task: Reuse a pre-trained model (trained on millions of images) as a feature extractor, and only train a new classification head on top
Two forms of transfer learning:
| From | To | |
|---|---|---|
| Ours | Phase 1 (8 types) | Phase 2 (38 patterns) |
| MobileNetV2 | ImageNet (millions of images) | Wafer defect classification |
Custom CNN Architecture
Phase 1 Task: Predict which of the 8 base defect types are present (multi-label, 8 sigmoid outputs)
Model: custom_cnn — Total params: 424,264 (1.62 MB)
| Layer | Shape | Params |
|---|---|---|
| input_image (Input) | (52, 52, 3) | 0 |
| conv2d (Conv2D) | (52, 52, 32) | 896 |
| batch_norm | (52, 52, 32) | 128 |
| activation (ReLU) | (52, 52, 32) | 0 |
| max_pooling2d | (26, 26, 32) | 0 |
| conv2d_1 (Conv2D) | (26, 26, 64) | 18,496 |
| batch_norm_1 | (26, 26, 64) | 256 |
| activation_1 (ReLU) | (26, 26, 64) | 0 |
| max_pooling2d_1 | (13, 13, 64) | 0 |
| conv2d_2 (Conv2D) | (13, 13, 128) | 73,856 |
| Layer | Shape | Params |
|---|---|---|
| batch_norm_2 | (13, 13, 128) | 512 |
| activation_2 (ReLU) | (13, 13, 128) | 0 |
| max_pooling2d_2 | (6, 6, 128) | 0 |
| conv2d_3 (Conv2D) | (6, 6, 256) | 295,168 |
| batch_norm_3 | (6, 6, 256) | 1,024 |
| activation_3 (ReLU) | (6, 6, 256) | 0 |
| max_pooling2d_3 | (3, 3, 256) | 0 |
| global_avg_pool | (256) | 0 |
| dense (ReLU) | (128) | 32,896 |
| dropout (0.5) | (128) | 0 |
| output (Sigmoid) | (8) | 1,032 |
Design choices:
- Doubling filters (32→256): Early layers detect simple features (edges), deeper layers detect complex patterns (rings, scratches) — more filters = more capacity for complexity
- 3×3 kernels: Standard efficient choice — captures local spatial relationships
- GlobalAveragePooling over Flatten: reduces parameters from ~2,304 to 256, fighting overfitting
MobileNetV2 Architecture
Model: mobilenet_transfer — Total params: 2,587,988 (9.87 MB)
| Layer | Output Shape | Params |
|---|---|---|
| input_image (Input) | (52, 52, 3) | 0 |
| conv2d_4 (Conv2D) | (52, 52, 3) | 12 |
| resizing (Resizing) | (224, 224, 3) | 0 |
| mobilenetv2 (Functional) | (7, 7, 1280) | 2,257,984 |
| global_average_pooling2d_1 | (1280) | 0 |
| dense_1 (Dense, ReLU) | (256) | 327,936 |
| dropout_1 (Dropout) | (256) | 0 |
| output (Dense, Sigmoid) | (8) | 2,056 |
Why MobileNetV2?
- Pre-trained on ImageNet → already knows edges, textures, shapes
- Lightweight architecture → efficient inference
- 1×1 Conv projection: Our data has 3 one-hot channels, not RGB — this layer learns the right mapping
- Frozen backbone: With only ~38K samples, fine-tuning 2.2M parameters risks overfitting
Phase 2: Two-Stage Training Details
Task: Classify each wafer into exactly one of 38 defect patterns using softmax. We reuse the Phase 1 backbone (frozen) and replace the head with Dense(128) → Dropout → Dense(38, softmax).
|
Stage A — Head Only Backbone: FROZEN LR: 1e-3 Epochs: ~30 Train new head only |
→ |
Stage B — Fine-Tune Backbone: Last 25% UNFROZEN LR: 1e-5 Epochs: ~30 Fine-tune end-to-end |
Why two stages?
- Stage A (head-only): The new Dense layers have random weights. Training at high LR while backbone is frozen lets them “catch up” without destroying pre-trained weights.
- Stage B (fine-tune): Unfreeze the last ~25% of backbone, train at very low LR (1e-5). Adapts features for the 38-class task while preserving prior knowledge.
- BatchNorm layers stay frozen — their statistics are from Phase 1 and shouldn’t shift.
Loss: sparse_categorical_crossentropy with balanced class weights
Model Overview
| Model | Task | Output |
|---|---|---|
| Phase 1 — Custom CNN | 8 labels | Sigmoid × 8 |
| Phase 1 — MobileNetV2 | 8 labels | Sigmoid × 8 |
| Phase 2 — Custom CNN | 38 classes | Softmax × 38 |
| Phase 2 — MobileNetV2 | 38 classes | Softmax × 38 |
Summary
What We Built
- A two-phase deep learning pipeline for wafer defect classification
- Phase 1: Multi-label detection of 8 base defect types
- Phase 2: Precise identification of all 38 defect patterns
- Two architectures: custom CNN and MobileNetV2 transfer learning
Key Technical Decisions
- One-hot pixel encoding → preserves categorical nature
- Focal Loss + class weights → handles severe imbalance
- Backbone reuse → leverages Phase 1 knowledge for Phase 2
- Two-stage fine-tuning → safe adaptation without catastrophic forgetting
- Geometric-only augmentation → respects discrete pixel states
Anomaly Detection in Semiconductor Manufacturing